2026 Muallif: Howard Calhoun | calhoun@techconfronts.com. Oxirgi o'zgartirilgan: 2025-01-24 13:27:15
Ion implantatsiyasi - bu past haroratli jarayon bo'lib, uning yordamida bitta elementning tarkibiy qismlari gofretning qattiq yuzasiga tezlashadi va shu bilan uning fizik, kimyoviy yoki elektr xususiyatlarini o'zgartiradi. Bu usul yarimo'tkazgichli qurilmalar ishlab chiqarishda va metallni pardozlashda, shuningdek materialshunoslik tadqiqotlarida qo'llaniladi. Komponentlar, agar ular to'xtab qolsa va unda qolsa, plastinkaning elementar tarkibini o'zgartirishi mumkin. Ion implantatsiyasi, shuningdek, atomlar yuqori energiyadagi nishon bilan to'qnashganda kimyoviy va fizik o'zgarishlarga olib keladi. To'qnashuvlarning energiya kaskadlari natijasida plastinkaning kristalli tuzilishi shikastlanishi yoki hatto vayron bo'lishi mumkin va etarlicha yuqori energiya (10 MeV) zarralari yadroviy o'zgarishlarga olib kelishi mumkin.
Ion implantatsiyasining umumiy printsipi

Uskuna odatda kerakli element atomlari hosil boʻladigan manbadan, ular elektrostatik ravishda yuqori tezlikda tezlashtirilgan tezlatgichdan iborat.energiya va maqsadli kameralar, ular maqsad bilan to'qnashadi, ya'ni material. Shunday qilib, bu jarayon zarracha nurlanishining alohida holatidir. Har bir ion odatda bitta atom yoki molekuladir va shuning uchun nishonga joylashtirilgan materialning haqiqiy miqdori ion oqimining vaqt integralidir. Bu raqam doza deb ataladi. Implantlar tomonidan ta'minlangan oqimlar odatda kichik (mikroamperlar) va shuning uchun o'rtacha vaqt ichida implantatsiya qilinishi mumkin bo'lgan miqdor kichikdir. Shuning uchun ion implantatsiyasi zarur bo'lgan kimyoviy o'zgarishlar soni kam bo'lgan hollarda qo'llaniladi.
Odatiy ion energiyalari 10 dan 500 keV gacha (1600 dan 80000 aJ gacha). Ion implantatsiyasi 1 dan 10 keV (160 dan 1600 aJ) gacha bo'lgan past energiyalarda qo'llanilishi mumkin, ammo kirish bir necha nanometr yoki undan kamroq. Bundan pastroq quvvat nishonga juda kam zarar yetkazadi va ion nurlarining cho'kishi belgisiga tushadi. Va yuqori energiyalardan ham foydalanish mumkin: 5 MeV (800 000 aJ) ga ega bo'lgan tezlatgichlar keng tarqalgan. Biroq, ko'pincha nishonga juda ko'p tizimli zarar etkaziladi va chuqurlikning tarqalishi keng bo'lgani uchun (Bragg cho'qqisi), maqsadning istalgan nuqtasida tarkibning aniq o'zgarishi kichik bo'ladi.
Ionlarning energiyasi, shuningdek, har xil turdagi atomlar va nishonning tarkibi zarrachalarning qattiq jismga kirish chuqurligini aniqlaydi. Monoenergetik ion nurlari odatda keng chuqurlik taqsimotiga ega. O'rtacha penetratsiya diapazon deb ataladi. DAodatdagi sharoitda u 10 nanometr va 1 mikrometr orasida bo'ladi. Shunday qilib, past energiyali ion implantatsiyasi, ayniqsa, kimyoviy yoki strukturaviy o'zgarishlar maqsadli sirtga yaqin bo'lishi kerak bo'lgan hollarda foydalidir. Zarrachalar qattiq jismdan oʻtayotganda, ham maqsadli atomlar bilan tasodifiy toʻqnashuv (bu keskin energiya almashinuvini keltirib chiqaradi) natijasida ham, uzluksiz jarayon boʻlgan elektron orbitallarning bir-birining ustiga chiqishi natijasida bir oz sekinlashuv natijasida ham oʻz energiyasini asta-sekin yoʻqotadi. Maqsaddagi ionlarning energiya yo'qotilishi to'xtash deb ataladi va ikkilik to'qnashuvning ion implantatsiyasi usuli yordamida modellashtirilishi mumkin.
Tezlashtiruvchi tizimlar odatda oʻrta oqim, yuqori oqim, yuqori energiya va juda muhim dozalarga boʻlinadi.
Ion implantatsiyasi nurlarining barcha turlarida funktsional komponentlarning ma'lum umumiy guruhlari mavjud. Misollarni ko'rib chiqing. Ion implantatsiyasining birinchi jismoniy va fizik-kimyoviy asoslari zarrachalarni hosil qilish uchun manba sifatida ma'lum bo'lgan qurilmani o'z ichiga oladi. Ushbu qurilma nur chizig'iga atomlarni ajratib olish uchun noaniq elektrodlar bilan chambarchas bog'liq va ko'pincha tezlatgichning asosiy qismiga tashish uchun muayyan rejimlarni tanlashning ba'zi vositalari bilan chambarchas bog'liq. "Masa" ni tanlash ko'pincha olingan ion nurining magnit maydon hududidan o'tishi bilan birga bo'ladi, bu esa faqat massa va tezlik mahsulotining ma'lum bir qiymatiga ega bo'lgan ionlarni to'sib qo'yish imkonini beradigan teshiklar yoki "tirqishlar" bilan cheklangan chiqish yo'li bilan chegaralanadi.. Agar maqsadli sirt ion nurining diametridan kattaroq bo'lsa vaagar implantatsiya qilingan doza unga tengroq taqsimlangan bo'lsa, u holda nurni skanerlash va plastinka harakatining ba'zi kombinatsiyasi qo'llaniladi. Nihoyat, maqsad implantatsiya qilingan ionlarning to'plangan zaryadini yig'ishning qandaydir yo'li bilan bog'langan bo'lib, etkazib berilgan dozani doimiy ravishda o'lchash va jarayonni kerakli darajada to'xtatish mumkin bo'ladi.
Yarim o'tkazgichlar ishlab chiqarishda qo'llanilishi
Bor, fosfor yoki mishyak bilan doping bu jarayonning keng tarqalgan qo'llanilishidir. Yarimo'tkazgichlarni ion implantatsiyasida har bir dopant atomi tavlanishdan keyin zaryad tashuvchini yaratishi mumkin. Siz p-tipli dopant va n-tipli elektron uchun teshik qurishingiz mumkin. Bu uning yaqinidagi yarimo'tkazgichning o'tkazuvchanligini o'zgartiradi. Texnika, masalan, MOSFET chegarasini sozlash uchun ishlatiladi.
Ion implantatsiyasi 1970-yillarning oxiri va 1980-yillarning boshlarida fotovoltaik qurilmalarda pn-birikmasini olish usuli sifatida ishlab chiqilgan, ammo u hozirgi kunga qadar tijoratlashtirilmagan bo'lsa-da, tezkor tavlanish uchun impulsli elektron nurdan foydalanish.
Izolyatordagi kremniy

Ushbu materialni an'anaviy kremniy substratlardan izolyator (SOI) substratlarida ishlab chiqarishning taniqli usullaridan biri SIMOX (kislorod implantatsiyasi orqali ajratish) jarayoni bo'lib, unda yuqori dozali havo kremniy oksidiga aylanadi. yuqori haroratli tavlanish jarayoni.
Mezotaksiya
Bu kristalografik oʻsish atamasiasosiy kristall yuzasi ostidagi mos keladigan faza. Ushbu jarayonda ionlar ikkinchi faza qatlamini yaratish uchun materialga etarlicha yuqori energiya va dozada implantatsiya qilinadi va maqsadli struktura buzilmasligi uchun harorat nazorat qilinadi. Qatlamning kristall yo'nalishi maqsadga muvofiq ishlab chiqilishi mumkin, hatto aniq panjara doimiysi juda boshqacha bo'lishi mumkin. Masalan, kremniy gofretga nikel ionlarini joylashtirgandan so'ng, kristall yo'nalishi kremniynikiga mos keladigan silitsid qatlami o'stirilishi mumkin.
Metal qoplama ilovasi

Azot yoki boshqa ionlar po'latdan yasalgan nishonga (masalan, matkap) joylashtirilishi mumkin. Strukturaviy oʻzgarish materialda sirt siqilishiga olib keladi, bu esa yoriqlar tarqalishini oldini oladi va shu bilan uni sinishga chidamliroq qiladi.
Yuzat qoplamasi

Ba'zi ilovalarda, masalan, sun'iy bo'g'inlar kabi protezlar uchun ham kimyoviy korroziyaga, ham ishqalanish tufayli aşınmaya yuqori darajada chidamli nishonga ega bo'lish maqsadga muvofiqdir. Ion implantatsiyasi yanada ishonchli ishlash uchun bunday qurilmalarning sirtlarini loyihalash uchun ishlatiladi. Asbob po'latlarida bo'lgani kabi, ion implantatsiyasi natijasida maqsadli o'zgartirish ham yoriqlar tarqalishining oldini olish uchun sirtni siqish va korroziyaga kimyoviy jihatdan chidamliroq qilish uchun qotishmalarni o'z ichiga oladi.
Boshqailovalar

Implantatsiya ion nurlarini aralashtirish, ya'ni interfeysda turli elementlar atomlarini aralashtirish uchun ishlatilishi mumkin. Bu tekis yuzalarga erishish yoki bir-biriga aralashmaydigan materiallar qatlamlari orasidagi yopishqoqlikni kuchaytirish uchun foydali bo'lishi mumkin.
Nanozarrachalarning shakllanishi
Ion implantatsiyasi safir va kremniy dioksidi kabi oksidlardagi nano o'lchamdagi materiallarni induktsiya qilish uchun ishlatilishi mumkin. Atomlar yog'ingarchilik yoki aralash moddalarning hosil bo'lishi natijasida hosil bo'lishi mumkin, ularda ion joylashtirilgan element va substrat mavjud.
Nanozarrachalarni olish uchun ishlatiladigan tipik ion nurlarining energiyalari 50 dan 150 kV gacha, ionlarning oqim oqimi esa 10-16 dan 10-18 kV gacha. qarang: 1 nm dan 20 nm gacha bo‘lgan o‘lchamdagi va implantatsiyalangan zarrachalarni o‘z ichiga olishi mumkin bo‘lgan kompozitsiyalar, faqat substrat bilan bog‘langan kationdan iborat birikmalar bilan turli xil materiallar yaratilishi mumkin.
Metal ioni implantatsiyasining dispers nanozarralarini o'z ichiga olgan sapfir kabi dielektrik asosli materiallar optoelektronika va chiziqli bo'lmagan optika uchun istiqbolli materiallardir.
Muammolar
Har bir alohida ion zarba yoki oraliqda maqsadli kristalda koʻplab nuqta nuqsonlarini hosil qiladi. Bo'sh joylar - bu atom egallamaydigan panjara nuqtalari: bu holda ion maqsadli atom bilan to'qnashadi, bu esa unga katta miqdordagi energiyani o'tkazishga olib keladi, shuning uchun u o'z qismini tark etadi.syujet. Ushbu maqsadli ob'ektning o'zi qattiq jismdagi o'qga aylanadi va ketma-ket to'qnashuvlarga olib kelishi mumkin. Interstitslar bunday zarralar qattiq jismda to'xtaganda, lekin panjarada yashash uchun bo'sh joy topmaganda paydo bo'ladi. Ion implantatsiyasi vaqtidagi bu nuqta nuqsonlari bir-biri bilan ko‘chib o‘tishi va to‘planishi mumkin, bu esa dislokatsiya halqalari va boshqa muammolarga olib keladi.
Amorfizatsiya
Kristallografik shikastlanish miqdori maqsadli sirtni to'liq o'tkazish uchun etarli bo'lishi mumkin, ya'ni u amorf qattiq holatga aylanishi kerak. Ba'zi hollarda nishonning to'liq amorfizatsiyasi yuqori darajadagi nuqsonli kristaldan afzalroqdir: bunday plyonka jiddiy shikastlangan kristalni tavlash uchun zarur bo'lgandan pastroq haroratda qayta o'sishi mumkin. Substratning amorfizatsiyasi nurlarning o'zgarishi natijasida yuzaga kelishi mumkin. Masalan, 510-16 Y+/sq gacha bo'lgan 150 keV nurlanish energiyasida itriy ionlarini sapfirga implantatsiya qilishda. sm, qalinligi taxminan 110 nm bo'lgan shishasimon qatlam hosil bo'ladi, tashqi yuzasidan o'lchanadi.
Spray

Ba'zi to'qnashuv hodisalari atomlarning sirtdan chiqib ketishiga olib keladi va shu bilan ion implantatsiyasi sirtdan asta-sekin chiqib ketadi. Ta'sir faqat juda katta dozalarda seziladi.
Ion kanal

Maqsadga kristallografik struktura qoʻllanilsa, ayniqsa yarimoʻtkazgichli substratlarda u koʻproqochiq bo'lsa, keyin aniq yo'nalishlar boshqalarga qaraganda ancha kamroq to'xtaydi. Natijada, agar ion ma'lum bir yo'l bo'ylab harakatlansa, masalan, kremniy va boshqa olmos kubik materiallarida harakat qilsa, uning diapazoni ancha katta bo'lishi mumkin. Ushbu ta'sir ion kanalizatsiyasi deb ataladi va shunga o'xshash barcha effektlar kabi juda chiziqli bo'lmagan, ideal yo'nalishdan kichik og'ishlar implantatsiya chuqurligida sezilarli farqlarga olib keladi. Shu sababli, ko‘pchilik o‘qdan bir necha daraja chetga ishlaydi, bunda kichik tekislash xatolari oldindan taxmin qilinadigan ta’sirga ega bo‘ladi.
Tavsiya:
Elektromagnit haydovchi: turlari, maqsadi, ishlash printsipi

Bugungi kunda ixcham, samarali va funktsional harakatlantiruvchi mexanizmlarni qo'llashda og'ir sanoatdan tortib transport va uy xo'jaliklarigacha inson faoliyatining deyarli barcha sohalari qiziqish uyg'otmoqda. Bu, shuningdek, quvvat bloklarining an'anaviy kontseptsiyalarini doimiy ravishda takomillashtirishning sababidir, garchi ular takomillashib borayotgan bo'lsa-da, asosiy qurilmani o'zgartirmaydi. Ushbu turdagi eng mashhur asosiy tizimlar elektromagnit haydovchini o'z ichiga oladi
Dvigatellar tasnifi. Dvigatellarning turlari, ularning maqsadi, qurilmasi va ishlash printsipi

Hozirgi kunda aksariyat avtomobillar dvigatel bilan ishlaydi. Ushbu qurilmaning tasnifi juda katta va juda ko'p sonli turli xil dvigatellarni o'z ichiga oladi
Pulsiz qanday qilib pul ishlash mumkin? Pul ishlash usullari. O'yinda qanday qilib haqiqiy pul ishlash mumkin

Bugun hamma yaxshi pul ishlashi mumkin. Buning uchun siz bo'sh vaqtingiz, xohishingiz va ozgina sabr-toqatga ega bo'lishingiz kerak, chunki hamma narsa birinchi marta amalga oshmaydi. Ko'pchilikni savol qiziqtiradi: "Pulsiz qanday qilib pul topish mumkin?" Bu mutlaqo tabiiy istak. Axir, hamma ham o'z pullarini, agar mavjud bo'lsa, masalan, Internetga investitsiya qilishni xohlamaydi. Bu xavf va juda katta xavf. Keling, bu masala bilan shug'ullanamiz va vlo holda Internetda pul ishlashning asosiy usullarini ko'rib chiqamiz
Tuproqning drenajlanishi: tushunchasi, maqsadi, ish usullari va usullari

Tuproqlarni sug'orish va quritish o'simliklarning normal o'sishi va rivojlanishi uchun sharoitlarni yaxshilashga qaratilgan juda muhim chora-tadbirlardir. Ajam fermerlarning ko'pchiligida yuqori sifatli sug'orish haqida savollar yo'q, lekin hamma ham drenaj nima ekanligini bilmaydi. Xo'sh, nima uchun tuproqni quritish kerak, qanday hollarda buni qilish kerak, bu protsedurani qanday qilib to'g'ri bajarish kerak va u nima beradi
Titanni qayta ishlash: materialning dastlabki xususiyatlari, qiyinchiliklari va qayta ishlash turlari, ishlash printsipi, texnikasi va mutaxassislarning tavsiyalari
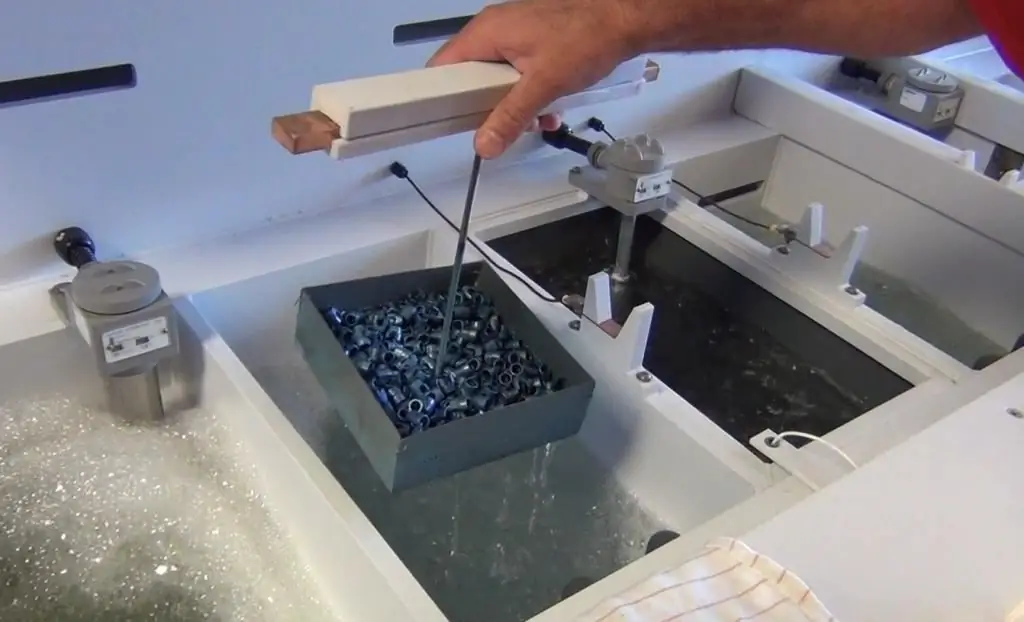
Bugungi kunda odamlar turli xil materiallarga ishlov berishmoqda. Titanni qayta ishlash eng muammoli ish turlari orasida ajralib turadi. Metall ajoyib fazilatlarga ega, ammo ular tufayli muammolarning aksariyati paydo bo'ladi

